KANZACC 最适于半导体装置及电子零部件引线框架的复合电镀开发
古河电工集团旗下的株式会社KANZACC(总公司:大阪市,社长:石桥久和,以下称为本公司)开发了耐热性及抗裂性良好的复合电镀,其最适合用于半导体装置及电子零部件的引线框架的电镀。
生产半导体装置及电子零部件时,需要用环氧树脂等将各个部件外装到引线框架上,特别是面安装型,要将引线框架的引脚弯成L形等,这样就比较容易将其焊接到配线印刷电路板上。另外,引线框架的材料为铁合金或铜合金,但该材料并不能直接焊接,因此还要为其镀上锡或锡合金(以下称为镀锡(合金)。这种情况下,一般先在引线框架上进行基底电镀,然后再镀锡(合金)。
但是,为了使半导体装置或电子零部件的外装环氧树脂完全硬化,需要进行热处理,这样就会导致基底和锡(合金)皮膜扩散,锡(合金)皮膜减少,或者将引线框架弯成L形时基底出现裂缝的问题。这些都可能导致将半导体装置或电子零部件焊接到配线印刷电路板上时出现接触不良的问题。
本公司开发的复合电镀,可以组合完成镀锡(合金)及最优的基底电镀,其优质的电镀皮膜具有较好的耐热性,且弯曲时不会开裂。
本公司的目标是在2014年后半年将该复合电镀用于实际生产,预计2015年销售收入可达2亿日元。
优点
- 进行热处理时,锡(合金)皮膜和基底不会发生扩散反应,镀锡(合金)皮膜不会减少,维持良好的焊接性能。
- 镀锡(合金)后的引线框架的L形弯曲部位不会发生开裂,维持良好的焊接性能。
结构
对引线框架(材料)进行复合电镀复合电镀 <基底电镀/镀锡(合金)>
用途
半导体及电子零部件的引线框架的电







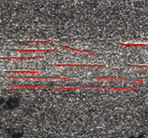

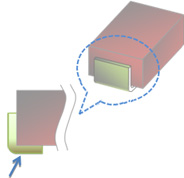
 Share
Share Tweet
Tweet Share
Share