成功开发出有助于大幅提高半导体质量的新型“半导体用胶带”
~将作为“激光刻槽(沟槽加工)+等离子切割加工法”专用部件开始正式量产~
本公司成功开发出了“激光刻槽(沟槽加工)+等离子切割加工法”(注释1)专用的新型半导体用胶带“带等离子掩膜的背磨(BG)胶带”及“扩张分割用切割和芯片粘结薄膜(D-DAF)”。在不断推进电子设备高功能化的背景下,作为有助于提高半导体质量的产品,将于2017 年度下半年开始正式量产。
背景
半导体广泛用于家电产品、手机、社会基础设施及汽车等领域,已成为日常生活中不可或缺的存在。特别是近几年,随着智能手机等的高功能化需求的出现,人们对集成化的需求也越来越高,于是不断开发出了搭载堆叠了数层半导体芯片的半导体零部件的电子设备,从而对半导体芯片的薄化提出了更高要求。因这种芯片薄化的需求,半导体晶圆便需要进一步实现薄膜化,于是为了实现该目标,人们提出了各种各样的制造方式。特别是在从半导体晶圆上切割各半导体芯片的制造工序(切割)方面,相较于机械加工方式,通过等离子照射进行切割的“激光刻槽(沟槽加工)+等离子切割加工法”在成品率及质量方面优势明显,预计这种方式今后将会成为世界主流的加工法。

(注释 1)激光刻槽(沟槽加工)+等离子切割加工法:
Panasonic Factory Solutions与东京精密协作完成的切割加工法。是在晶圆的街区部照射等离子,通过气体蚀刻实施去除的干法切割方式。因为没有机械式加工,相较于过去的方式(机械切割方式),其在提高成品率与质量方面优势明显。可根据所使用气体的种类选择要切割的对象。
内容
此次,作为“激光刻槽(沟槽加工)+等离子切割加工法”的专用部件,本公司在世界上首次成功开发出了新型半导体用胶带“带等离子掩膜的背磨(BG)胶带”及“扩张分割用切割和芯片粘结薄膜(D-DAF)”。
“带等离子掩膜的背磨(BG)胶带”,是同时兼具半导体晶圆背面研磨时的晶圆表面保护功能及等离子照射时的晶圆表面保护功能的胶带。在背面研磨(以下简称“BG”)工序(注释2)中,与普通的 BG 胶带同样,可进行半导体晶圆的薄膜化切削,并且在BG后,可仅剥离BG 胶带,将等离子掩膜(注释3)的层留在晶圆表面,从而形成用来保护表面免受等离子照射侵害的掩膜层。因为该等离子掩膜层对等离子切割时的蚀刻气体具有耐受性,所以在等离子切割时,其作为掩膜层对晶圆表面加以保护,而在等离子切割后,切换气体种类便能让其丧失耐受性,因此可将其完全去除。

“扩张分割用切割和芯片粘结薄膜(D-DAF)”在通过等离子照射进行切割后,通过对切割胶带进行扩张来分割(注释4)芯片粘结薄膜(以下简称“DAF”)。因为DAF的分割性良好,所以可轻松实现半导体芯片+DAF的拾取。
每种产品均可直接使用原来的BG胶带叠层~BG胶带剥离、扩张分割~拾取工序的装置。
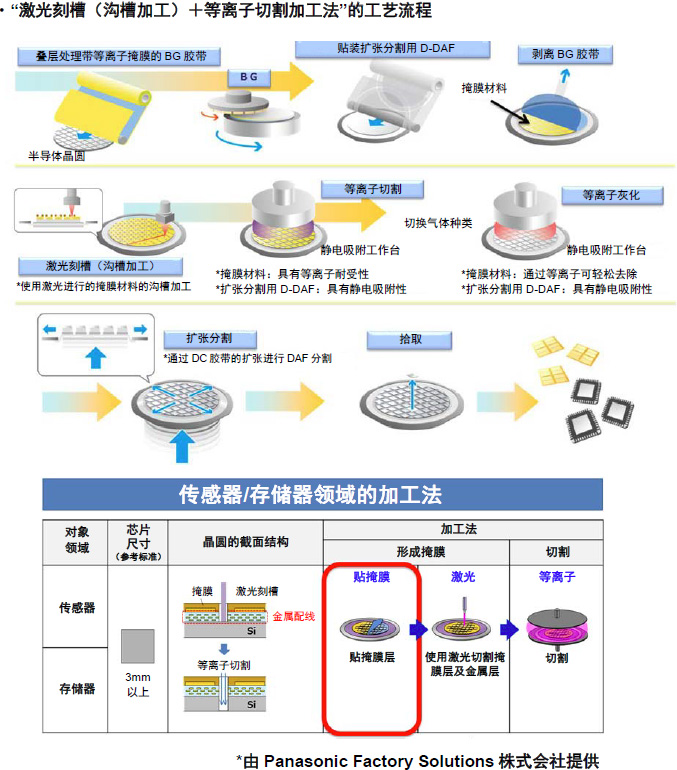
(注释 2)背磨(BG)工序:
将晶圆背面切削至指定厚度的切削工序。
(注释 3)等离子掩膜:
在等离子照射时保护图案面免受损伤的膜。
(注释 4)扩张分割:
将经等离子照射而切割后的晶圆往 360°方向延伸,以方便拾取等操作的工序。
特点、数据规格
1.带等离子掩膜的背磨胶带
- 本品是由BG胶带与等离子掩膜构成的多层结构,在BG工序后,可从BG胶带与等离子掩膜的界面进行剥离。
- 形状为卷状,长度基本上是100m/卷。胶带的厚度因品种而异,为100~200μm。
2. 扩张分割用切割和芯片粘结薄膜
- 通过等离子照射进行晶圆切割后,通过对切割胶带进行扩张来分割DAF。因为DAF的分割性良好,所以可轻松实现半导体芯片+DAF的拾取。
- 形状为圆形的DAF粘合在切割胶带上的卷状。长度基本上是100m/卷,胶带的厚度因品种而异,为100~200μm。
展会参展预定
预定将在2017/3/14~2017/3/16举办的“Semicon China”上参展。







 Share
Share Tweet
Tweet Share
Share